
近日,韩国LG Innotek宣布成功开发并量产全球首个应用于移动端的高价值半导体基板铜柱(Cu‑Post)互连技术。
LG Innotek表示,这一创新工艺已在量产产品中实现应用,标志着下一代智能手机封装工艺进入全新阶段。
传统半导体封装中,芯片与基板之间通过锡球互连,锡球体积与间距限制了电路布局密度。.
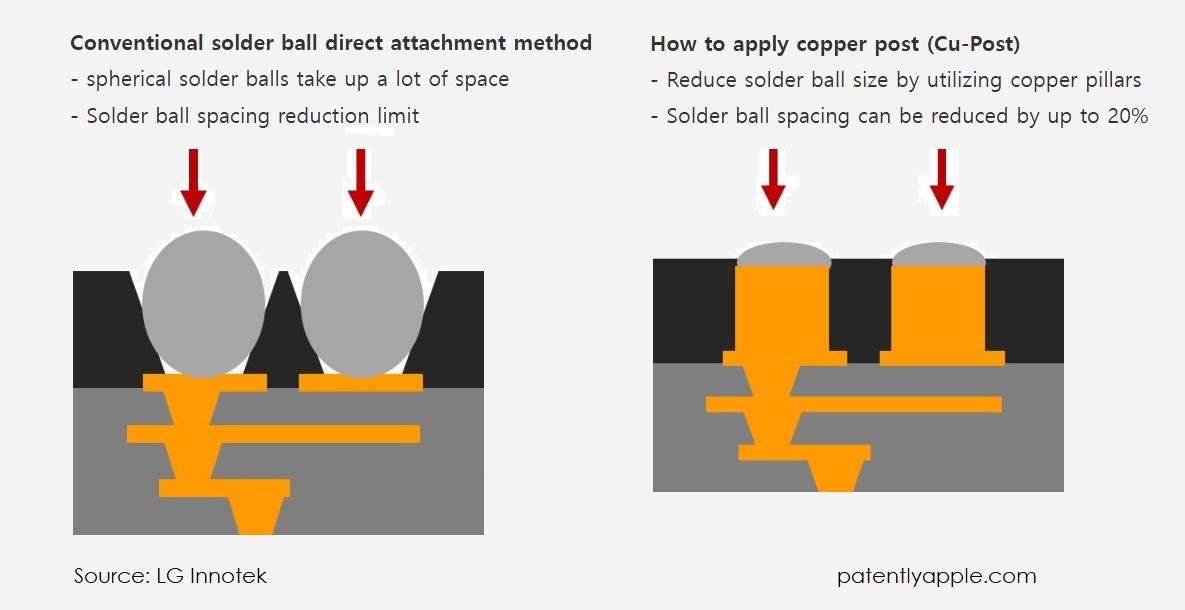
LG Innotek的铜柱技术则是在基板表面先微米级精准成形竖直铜柱,再在柱顶敷设小型焊球,实现电气连接,铜柱本身兼具电导率和机械强度,能够有效缩小互连尺寸并提升结构可靠性。
应用Cu‑Post技术后,保持既有性能水平的前提下,半导体基板尺寸最高可缩减20%,为智能手机主板设计提供更多空间。
此外,铜的导热系数约为传统焊球的七倍,显著提升热管理效率,有助于缓解高性能芯片在小型化封装中产生的散热压力,实现更高的布线密度,在同等面积内可部署更多电路单元,从而提高芯片封装的集成度。
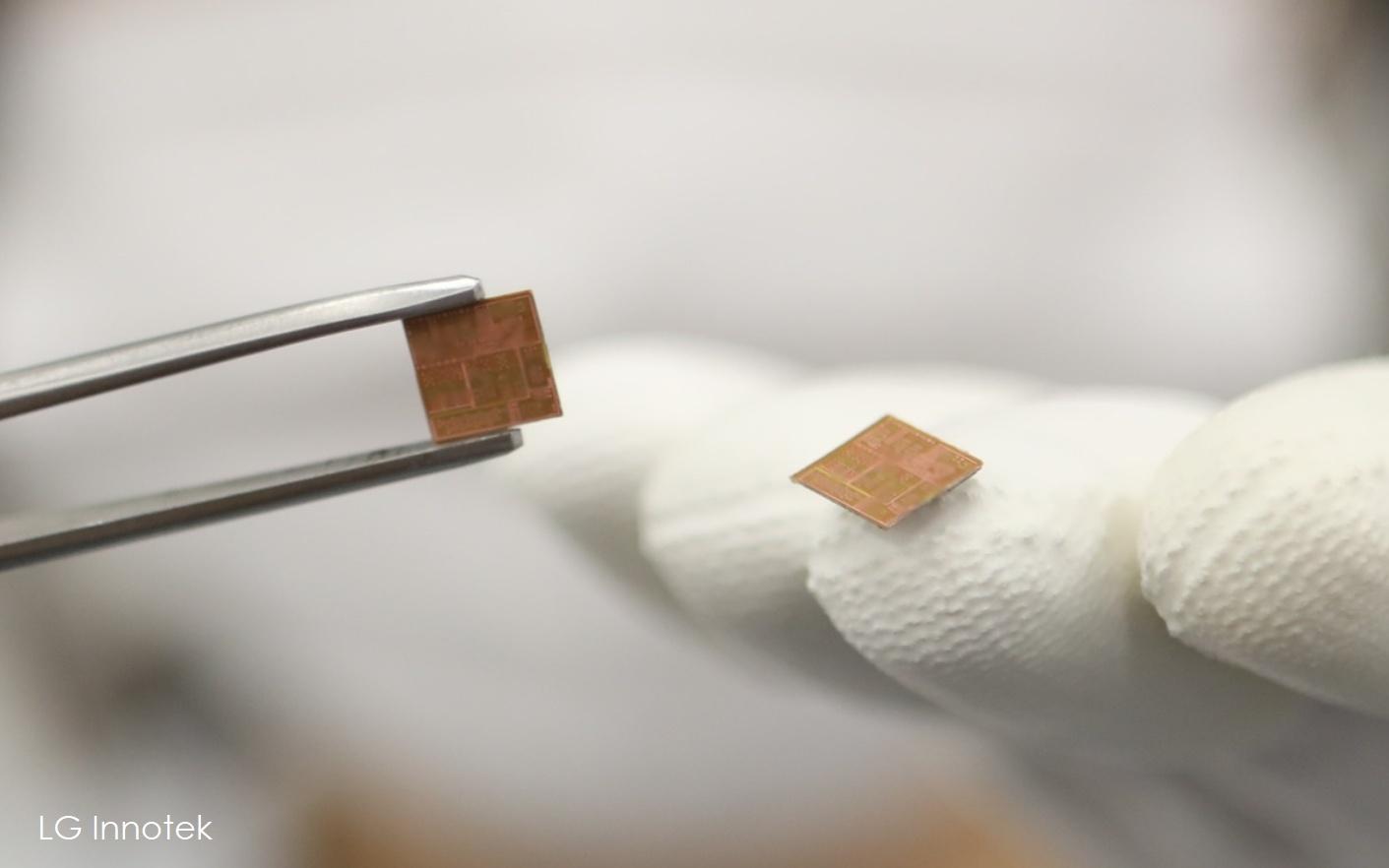
相关人士表示,自2021年启动Cu‑Post技术研发以来,LG Innotek已形成成熟的3D模拟与数字孪生验证流程,确保快速迭代与高良率量产,公司规划到2030年,将半导体组件业务——以高端移动基板与汽车应用处理器模块为核心——打造成年销售额3万亿韩元规模。
 )
)